說到這三個:埋孔、過孔、盲孔時!HDI小編知道,肯定有很大一部分人心中都沒有一個準確的概念,不知道該用在什么地方。今天我們就來介紹一下:
先分別說一下它們的概念:
過孔(Via):也稱之為通孔,是從頂層到底層全部打通的,在四層PCB中,過孔是貫穿1,2,3,4層,對不相干的層走線會有妨礙。過孔主要分為兩種:
1.沉銅孔PTH(Plating Through Hole),孔壁有銅,一般是過電孔(VIA PAD)及元件孔(DIP PAD)。
2.非沉銅孔NPTH(Non Plating Through Hole),孔壁無銅,一般是定位孔及螺絲孔
盲孔(Blind Via):只在頂層或底層其中的一層看得到,另外那層是看不到的,也就是說盲孔是從表面上鉆,但是不鉆透所有層。盲孔可能只要從1到2,或者從4到3(好處:1,2導通不會影響到3,4走線);而過孔是貫穿1,2,3,4層,對不相干的層走線有影響,.不過盲孔成本較高,需要鐳射鉆孔機。盲孔板應用于表面層和一個或多個內層的連通,該孔有一邊是在板子之一面,然后通至板子之內部為止;簡單點說就是盲孔表面只可以看到一面,另一面是在板子里的。一般應用在四層或四層以上的PCB板。
埋孔(Buried Via):埋孔是指做在內層過孔,壓合后,無法看到所以不必占用外層之面積,該孔之上下兩面都在板子之內部層,換句話說是埋在板子內部的。簡單點說就是夾在中間了,從表面上是看不到這些工藝的,頂層和底層都看不到的。做埋孔的好處就是可以增加走線空間。但是做埋孔的工藝成本很高,一般電子產品不采用,只在特別高端的產品才會有應用。一般應用在六層或六層以上的PCB板。
我當時看完這個感覺還是覺得不是很直觀,想想那就直接上一張圖吧!
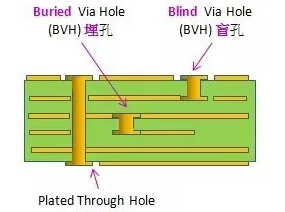
正片與負片:四層板,首先要搞明白的是正片和負片,就是layer和plane的區別。正片就是平常用在頂層和地層的的走線方法,既走線的地方是銅線,用Polygon Pour進行大塊敷銅填充。負片正好相反,既默認敷銅,走線的地方是分割線,也就是生成一個負片之后整一層就已經被敷銅了,要做的事情就是分割敷銅,再設置分割后的敷銅的網絡。在PROTEL之前的版本,是用Split來分割,而現在用的版本Altium Designer中直接用Line,快捷鍵PL,來分割,分割線不宜太細,我用30mil(約0.762mm)。要分割敷銅時,只要用LINE畫一個封閉的多邊形框,在雙擊框內敷銅設置網絡。正負片都可以用于內電層,正片通過走線和敷銅也可以實現。負片的好處在于默認大塊敷銅填充,在添加過孔,改變敷銅大小等等操作都不需要重新Rebuild,這樣省去了重新敷銅計算的時間。中間層用于電源層和地層時候,層面上大多是大塊敷銅,這樣用負片的優勢就較明顯。
采用盲孔和埋孔的優點:在非穿導孔技術中,盲孔和埋孔的應用,可以極大地降低HDI PCB的尺寸和質量,減少層數,提高電磁兼容性,增加電子產品特色,降低成本,同時也會使得設計工作更加簡便快捷。在傳統PCB設計和加工中,通孔會帶來許多問題。首先它們占居大量的有效空間,其次大量的通孔密集一處也對多層PCB內層走線造成巨大障礙,這些通孔占去走線所需的空間,它們密集地穿過電源與地線層的表面,還會破壞電源地線層的阻抗特性,使電源地線層失效。且常規的機械法鉆孔將是采用非穿導孔技術工作量的20倍。在PCB設計中,雖然焊盤、過孔的尺寸已逐漸減小,但如果板層厚度不按比例下降,將會導致通孔的縱橫比增大,通孔的縱橫比增大會降低可靠性。隨著先進的激光打孔技術、等離子干腐蝕技術的成熟,應用非貫穿的小盲孔和小埋孔成為可能,若這些非穿導孔的孔直徑為0.3mm,所帶來的寄生參數是原先常規孔的 1/10左右,提高了PCB的可靠性。由于采用非穿導孔技術,使得PCB上大的過孔會很少,因而可以為走線提供更多的空間。剩余空間可以用作大面積屏蔽用途,以改進EMI/RFI性能。同時更多的剩余空間還可以用于內層對器件和關鍵網線進行部分屏蔽,使其具有最佳電氣性能。采用非穿導孔,可以更方便地進行器件引腳扇出,使得高密度引腳器件(如 BGA 封裝器件)很容易布線,縮短連線長度,滿足高速電路時序要求。
采用盲孔和埋孔的缺點:最主要的缺點就是HDI板成本高,加工制做復雜。既增加成本還有加工風險,調試時會更不好測試測量,因此建議盡量不用盲孔和埋孔,除非在板子尺寸受限,迫不得已的情況下才用。

 通訊手機HDI
通訊手機HDI 通訊手機HDI
通訊手機HDI 通訊模塊HDI
通訊模塊HDI