今天咱們主要來分享一下BGA封裝的設計以及盲埋孔電路板應該怎樣來設計,首先講一下 BGA的定義:
一,BGA的概述:
90年代隨著集成技術的進步、設備的改進和深亞微米技術的使用,LSI、VLSI、ULSI相繼出現,硅單芯片集成度不斷提高,對集成電路封裝要求更加嚴格,I/O引腳數急劇增加,功耗也隨之增大。為滿足發展的需要,在原有封裝品種基礎上,又增添了新的品種——球柵陣列封裝,簡稱BGA(Ball Grid Array Package)。 設計工程師在設計BGA器件時將會面臨很多問題,布局和布線設計的瓶頸、設計的工藝是否能與加工企業相互匹配、設計 BGA 焊盤是否容易導致虛焊或容易短接、設計的規劃是否導致成本上漲等。

二,高密BGA器件的設計方法:
● BGA封裝要求
● BGA布局要求
● BGA布線要求
● 0.5MM BGA

三,BGA焊盤大小設置:
焊盤直徑=焊點中心間距/2
例:BGA1.0mm PAD=0.5mm
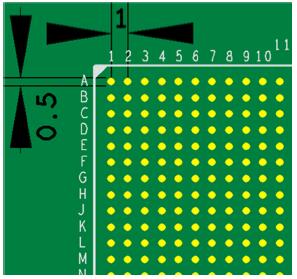
四,BGA焊盤阻焊設置:
BGA焊盤阻焊直徑=BGA焊盤直徑+4mil
例如:焊盤=20mil 焊盤阻焊=24mil
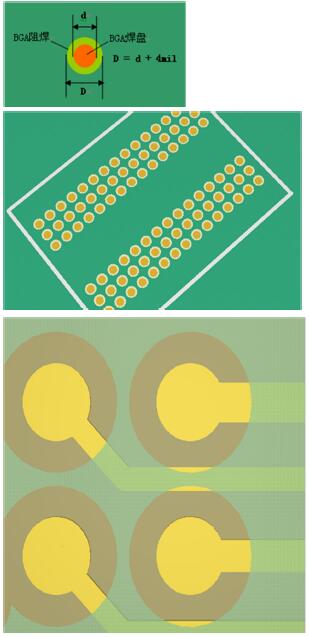
五,BGA過孔定義:
★通孔(through via):穿過整個線路板,可用于實現內部互連或作為元件的安裝定位孔。
★盲孔(blind via):位于印刷線路板的頂層和底層表面,具有一定深度,用于表層線路和下面的內層線路的連接,孔的深度通常不超過一定的比率(孔徑)。
★埋孔(buried via):位于印刷線路板內層的連接孔,它不會延伸到線路板的表面。
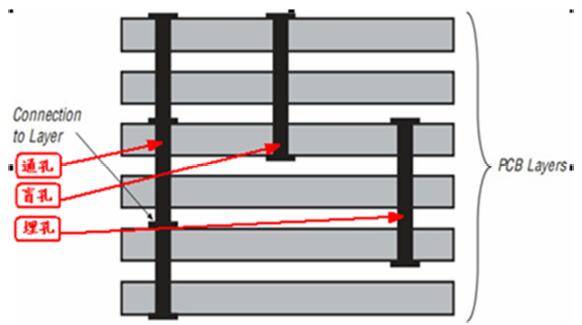
過孔參數設置:
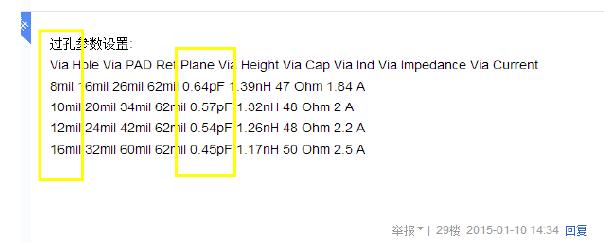

 通訊手機HDI
通訊手機HDI 通訊手機HDI
通訊手機HDI 通訊模塊HDI
通訊模塊HDI