如果必要,應該要快速檢討PTH制程,這些包含在生產雙面軟板的步驟,同時制程與設備可以用在軟硬結合板制作上,我們會假設軟板與蓋板層都有正確的設計,以提供期待的互連與尺寸,而正確的工具、鉆孔程式、底片與材料也都已經提供,工廠都具有良好的功能與效率,并進行嚴謹的制程控制。
到了這個階段材料會進行預機械加工、堆疊等處理,除些之外軟硬結合板生產大致上會與電路板及軟板生產類似。實際上多數軟硬結合板原材料如:蝕刻層等,都是電路板與軟板制造的產出物。從這個地方開始,軟硬結合板制程的特別作法才開始發生,此時我們也才面對特定軟硬結合板制作技巧。雖然軟硬結合板的基本制作概念相近,但是不同結構與表面狀況的軟硬結合板還是會有一些制程順序與半成本結構的差異。圖10-6所示,為日本某電路板廠商的軟硬結合板制程圖示。從資料中就可以看到,制程是采用表免銅皮覆蓋的結構進行制作,但是這種流程必然有其執行的難處。因為銅皮的強度相對比較差,只要在制程中的操作讓它產生破裂,內藏藥水的問題就會讓濕制程中的各種槽體相互污染,如果真的會發生這種問題,則這個制程的可行性就會受到質疑。不過如果是采用比較厚的銅皮支撐,同時采用內部填充的結構操作風險相對會降低,但是這種作法對于制作細線路的能力就會打折扣。
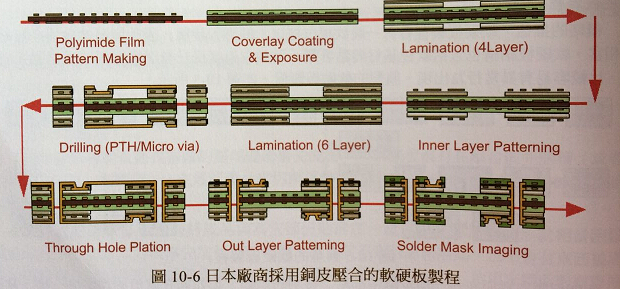
另外一個是筆者曾經用過的軟硬結合板制程,這種制程在完成軟硬結合板制程前,完全保持密封蓋的完整性避免讓藥水有侵入空區的風險。這種作法可以應對各類的軟硬結合制作需求,且制程穩定度也比較高。典型的作法如圖10-7所示。這種制程的優勢是,空區軟板在整個制程中都不會碰到藥水,因此就算軟板表面有暴露襯墊的結構,也不會產生任何后遺癥。不過因為蓋板必須在完成產品后清除,因此比需要找到不傷害軟板又能夠將硬式蓋板清除的方法。
傳統作法是利用深度控制的切形設備,進行所謂開蓋作業來處理,不過這種制程的深度控制能力有限,加上電路板的厚度會有變化也讓控制能力降低。某些廠商會采用雷射開蓋的技術來處理,不過設計制程的時候,必須要搭配工廠的工具系統與技術特長來規劃,否則會有清楚不完全與損傷軟板的風險。
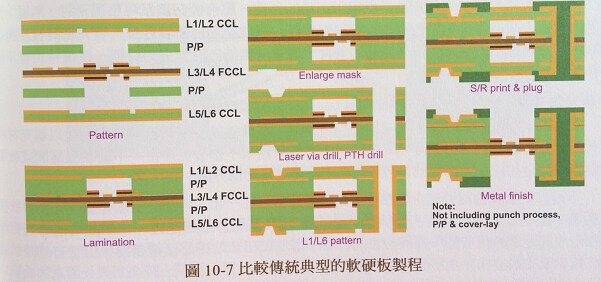
某些廠商在面對彎折軟板區沒有襯墊曝露的結構下,會采用無對蓋的制程結構進行生產。這種制程的軟硬結合板在通過濕制程時軟板會接觸到藥水,因此不能有任何 墊暴露,否則會產生不必要的侵蝕與沉積反應發生。這方面并不需要再用圖形描述,只要利用前述的流程圖形去除封蓋就是半成品狀態。這種制程的好處是,因為沒有蓋板成品在完成時不需要一片一片的進行深度控制清除封蓋的處理,這樣可以節省相當大的成本,而變折區可以用整疊的硬板基材直接切開再進行壓合。另外再制作超薄的軟硬結合板方面,因為沒有蓋板需求的限制,某些廠商會采用膠片直接壓合的作業方式制作,這種制程可以作出相當薄的軟硬結合板。
不過這種制程的缺點是,軟板區在經過除膠渣制程時會受到攻擊,因此要注意軟板覆蓋膜的選用與厚度設計,過低的厚度與比較強的除膠渣參數可能會過度損傷軟板而導致信賴會有偏低的結合力,如果這種低結合力的化學銅在制程中產生剝離,會造成槽液污染與制程困擾,這些方面目前還是沒有徹底解決的方法。

 通訊手機HDI
通訊手機HDI 通訊手機HDI
通訊手機HDI 通訊模塊HDI
通訊模塊HDI