電路板必須在待焊銅采取保護措施以確保焊錫性,但是對于高密度電路板而言,傳統的噴錫處理無法滿足許多高密度組裝的表面處理需求。多年前業者就推出過所謂的Entek制程,但是當時的配方及產業環境需求都不成熟,同時其耐候間十分的短,只有數小時到兩天之間。因此當時的應用,主要是放在一些廠內直接制作使用的情況下,對于一些專業的電路板制作廠商而言,并不是一種恰當的選項。
但是由于后續的配方有所改進,無鉛組裝的趨勢壓力、成本優勢以及產品高密度結構三者共同推進,目前在有機保焊膜方面的發展有了一定的成績。
市面上常銷售的有機保焊膜配方,主要是以BTA(苯駢三氯唑)、AI(烷基咪唑)、ABI(烷基苯咪唑)等等的有機配方為基礎所進行調制的產品。因為這些有機物都有許多不同的分子結構,因此相關的廠商對于自己的藥劑特性都列為機密,使用者幾乎只能在電路板的制作效果中進行了解與評估。
一般的有機保焊膜約有0.4um的厚度就可以達到多次熔焊的目的。雖說其廉價且操作性單純,但是仍然有以下的缺點:
1.OSP透明不易測量,目視亦難以檢查
2.膜厚太高不利于低固含量低活性免洗錫膏作業,有利于接合的Cu5Sn6 IMC也不易形成
3.多次組裝都必須在含氮環境下操作
4.若有局部鍍金再作OSP,則可能在其操作槽液中所含的銅會沉積于金上,對某些產品會形成問題
此類產品中最有名的,就以ENTHON所采用的苯駢三氯唑溶入甲醇于水溶液中出售的護銅劑為代表。其商品名稱以CU-XX為代號,不同的應用有不同的稱謂。BTA是白色帶淡黃無嗅之晶狀細粉,在酸堿中都很安定,且不易發生氧化還原反應,能與金屬形成安定化合物。這樣的機制可以與處理之銅面產生保護膜,防止裸銅迅速氧化以保有焊錫性。
另外一個比較知名的產品,則以日本的四國化成所推出的PREFLUX產品系列為代表。其本來的目的是開發用于蝕刻阻劑,并于1985年申請專利,但由于色呈現透明檢測不易未大量使用。其后推出GLICOAT等,系由此產品衍生而來。其基礎的配方則是以烷基咪唑為主,與銅的作用與考慮相類似。
這些有機物的共同特色就是可以與銅產生適當的錯合物,因此可以使銅不氧化并保有焊錫性。目前此類的產品系統有醋酸系統、甲酸系統以及松香系統三類,松香系統因為組裝后必須要有清洗的作業同時清潔不易,因此使用者十分的少。多數的藥液系統為使成長速率增快而升溫操作,水因之蒸發快速PH值控制不易。一般PH值提高時會導致Imidazole不溶而產生結晶,因此必須要將PH調回以取得改善。
目前有機保焊膜面對的最大挑戰,就是能否承受多次的焊接流程,同時能恰當的控制保焊膜厚度,使焊接能夠順利的進行又不會過分脆弱而被破壞。因為有機保焊膜的作用速度,與線路是否有連結大銅面有關,這在各種的化學處理中都有類似的現象,只是影響程度的差異有別而已。圖9.2所示,為有機保焊膜處理良好與不佳的狀況范例。
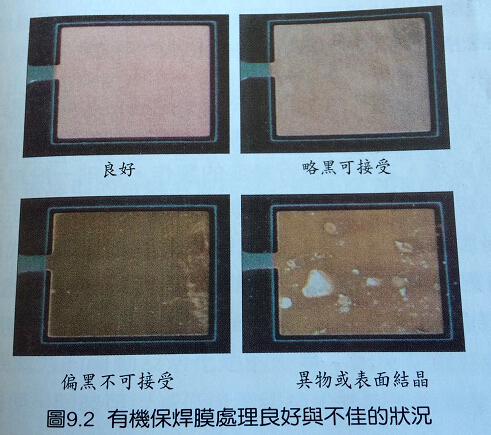

 通訊手機HDI
通訊手機HDI 通訊手機HDI
通訊手機HDI 通訊模塊HDI
通訊模塊HDI