PCB(印制電路板)的特殊工藝是指為了滿足特定功能或性能需求而采用的非標準制造技術。以下是一些常見的特殊工藝:
線路板信號完整性相關工藝
1. 阻抗控制(Impedance Control)
核心原理:通過精確計算PCB走線的寬度、介質層厚度和介電常數,控制傳輸線特性阻抗(如50Ω、90Ω、100Ω),確保與元器件的阻抗匹配。
設計要點:
層疊設計:通過調整介質層厚度(如PP片厚度)和銅厚,滿足阻抗要求。
材料選擇:高頻板材(如Rogers 4350B)可降低介電常數(Dk)變化對阻抗的影響。
仿真驗證:使用SI工具(如HyperLynx、ADS)進行阻抗仿真,避免信號反射和衰減。
應用場景:高速數字電路(DDR、PCIe)、射頻電路(5G天線、微波通信)。

2. 多次特殊疊層結構(Advanced Stack-up)
技術分類:
對稱疊層:減少板材熱應力變形(如8層板采用2+4+2對稱結構)。
混合介質疊層:結合FR-4與高頻材料(如PTFE),優化信號層與電源層分布。
埋容/埋阻層:在內部層嵌入電容/電阻材料,減少表面元件數量。
EMC優化:
通過“信號-地-信號”層疊順序,抑制串擾。
采用20H原則(電源層比地層內縮20倍介質厚度),降低邊緣輻射。
典型應用:服務器主板、汽車雷達模塊、航空航天電子系統。
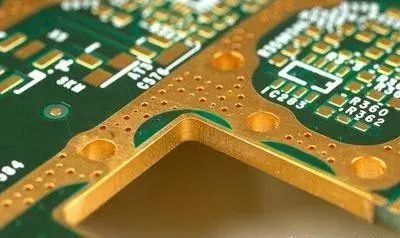
電路板高密度互連(HDI)工藝
1. 盲孔/埋孔技術(Blind/Buried Via)
工藝細節:
激光鉆孔:CO?或UV激光加工孔徑50-100μm的微孔。
填孔電鍍:使用導電膏或電鍍銅填充孔內,實現層間可靠連接。

設計優勢:
縮短信號路徑,提升高頻信號完整性(如減少via stub效應)。
支持BGA封裝下高密度走線(如0.4mm間距BGA逃逸布線)。
典型疊層:1+N+1(盲孔)、2+N+2(任意層互連)。
2. 沉頭孔(Counterbore)
加工方法:
使用平頭鉆針或CNC鑼刀分步鉆孔,形成階梯狀孔結構。
孔徑比標準過孔大,深度控制為板厚的50%-80%。
應用場景:
安裝沉頭螺絲,實現PCB與外殼的機械固定(如工業控制設備)。
避免傳統通孔導致的表面凸起,滿足超薄設備需求。

 通訊手機HDI
通訊手機HDI 通訊手機HDI
通訊手機HDI 通訊模塊HDI
通訊模塊HDI