7 結構完整性要求
HDI板結構完整性要求需在熱應力(Thermal stress)試驗后進行,熱應力試驗方法:依據IPC-TM-650-2.6.8條件B進行。除非特殊要求,要經過5次熱應力后切片。
金相切片的制作要求依照IPC-TM-650-2.1.1或2.1.1.2進行,垂直切片至少檢查3個孔。金相切片的觀察要求在100X ±5%的放大下進行,評判時在200X ±5%的放大下進行,鍍層厚度小于1um時不能用金相切片技術來測量。
7.1 鍍層完整性
[1] 金屬鍍層無裂紋、分離、空洞和污染物;
[2] 微孔底部和Target Pad之間不允許出現未除盡的膠渣或其他雜質。
7.2 介質完整性
測試后無剝離、氣泡、分層、軟化等現象。
7.3 微孔形貌
[1] 微孔直徑應滿足:B≥0.5×A
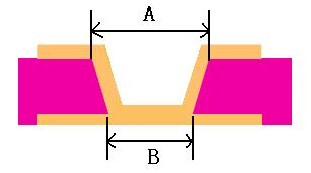
圖7.3-1 微孔形貌
(注:A—微孔頂部電鍍前直徑;B—微孔底部電鍍前直徑。)
[2] 微孔孔口不允許出現“封口”現象:
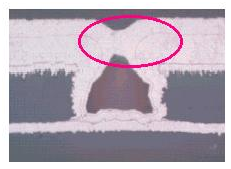
圖7.3-2 微孔孔口形貌
7.4 積層被蝕厚度要求
若采用Large Windows方式,積層介質在工藝過程中(如Desmear)被蝕厚度H≤10um。

圖7.4-1 積層被蝕厚度
7.5 埋孔塞孔要求
埋孔不能有可見空洞,凸、凹現象不能影響介質厚度的要求。
8 其他測試要求
8.1 附著力測試
表8.1-1 附著力測試要求
|
序號 |
測試目的 |
測試項目 |
測試方法 |
性能指標 |
備注 |
|---|---|---|---|---|---|
|
1 |
綠油附著力 |
膠帶測試 |
同《剛性PCB檢驗標準》 |
同《剛性PCB檢驗標準》,且不能露銅 |
需關注BGA塞孔區 |
|
2 |
金屬和介質附著力 |
剝離強度(Peel Strength) |
IPC-TM-650 2.4.8 |
≥5Pound/inch |
|
|
3 |
微孔盤浮離(Lift lands) |
熱應力測試(Thermal Stress) |
IPC-TM-650 2.6.8條件B |
5次測試后無盤浮離現象 |
|
|
4 |
表面安裝盤和NPTH孔盤附著力 |
拉脫強度測試(Bond Strength) |
IPC-TM-650-2.4.21.1 |
≥2kg或2kg/cm2 |

 通訊手機HDI
通訊手機HDI 通訊手機HDI
通訊手機HDI 通訊模塊HDI
通訊模塊HDI